IC ASSEMBLY AND PACKAGING
บทนํา
ในโลกของเทคโนโลยีการผลิตไอซีในปัจจุบันใช้เทคโนโลยีชั้นสูงในการผลิตโดยการผลิตทุกขั้นตอนจะใช้เครื่องจักรกลอัตโนมัติผลิตเพื่อให้ได้ผลิตภัณฑ์ที่มีคุณภาพสูงตรงตามคุณลักษณ์ที่ทางลูกค้าต้องการซึ่งเทคโนโลยีการผลิตไอซีในอนาคตมีการผลิตไอซีที่มีขนาดเล็ก ความหนาของตัวไอซีน้อย จํานวนขาไอซีมากโดยได้มีการพัฒนาจากกระบวนการผลิตไอซีที่ใช้ขา (Thru–Hole Technology) ไปเป็นเทคโนโลยีการผลิตไอซีแบบใช้ลูกบอล (Ball Grid Array)แทนไอซีแบบใช้ขาซึ่งเทคโนโลยีดังกล่าวจะลดขั้นตอนการชุบขาไอซีด้วยสารเคมีและสารตะกั่วเพื่อรักษาสิ่งแวดล้อมภายในโรงงานอุตสาหกรรมและชุมชนให้ปราศจากมลพิษที่อาจจะเกิดอันตรายได้ ส่วนรายละเอียดในกระบวนการผลิตเราจะได้ศึกษาต่อไป
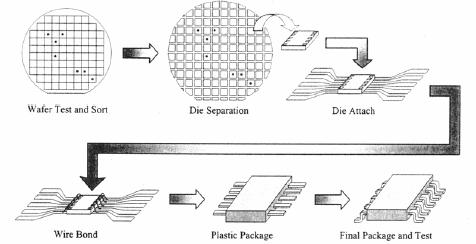
รูปที่ 3-1 แสดงลําดับขั้นการผลิตไอซี
3.1 กระบวนการประกอบไอซี (IC ASSEMBLY)
ตามที่เราได้ศึกษาถึงกระบวนการผลิตแผ่นเวเฟอร์ (Wafer) มาแล้วต่อไปเราจะได้ศึกษาถึงกระบวนการการประกอบ (Assembly) และกระบวนการบรรจุไอซี (IC Packaging) ในขบวนการประกอบตัวไอซีสามารถแบ่งการทํางานเป็นสองส่วนคือ
• ส่วนของการผลิต FOL (Front of Line)
• ส่วนของการผลิต EOL (End of Line)
3.1.1 ส่วนของการผลิต FOL
เป็นกระบวนการผลิตตั้งแต่การนําแผ่นเวเฟอร์ไปวัดความหนาและเจียรไนด้านหลังแผ่นให้ได้ขนาดความหนาตามต้องการไปจนถึงขบวนการเชื่อมลวดทอง (Wire Bond) ลงระหว่างได (Die)กับขาไอซี ซึ่งสามารถเขียนไดอะแกรมขั้นตอนการผลิตดังรูปที่ 3-2
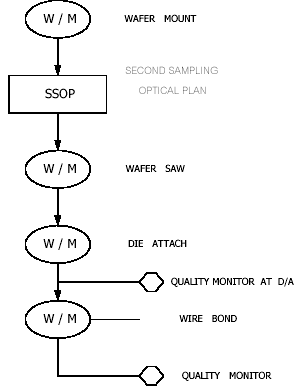
รูปที่ 3-2 บล็อคไดอะแกรมของกระบวนการประกอบไอซีส่วนของการผลิตส่วนหน้า
ในกระบวนการประกอบไอซีในส่วนของการผลิตไอซีในส่วนของการผลิตส่วนหน้า (Front ofline) หรือเรียกว่ากระบวนการ FOL กระบวนการประกอบไอซี จะกระทําในห้อง Clean Room ซึ่งห้องดังกล่าวจะต้องมีการควบคุมความสะอาด ฝุ่นละออง ความชื้น และอุณหภูมิ ภายในห้องประกอบไอซี โดยทางโรงงานมีการกําหนดเขตพื้นที่ Clean Area พนักงานที่จะเข้าไปในเขตดังกล่าวต้องสวมชุด Jump Suit และใช้ผ้าครอบปากและจมูก Jump Suit เป็นชุดป้องกันประจุไฟฟ้าสถิตย์ (Electro Static Discharge) ที่เกิดขึ้นที่ตัวมนุษย์ หรือตัวย่อคือ ESD ซึ่งชุด Jump Suitจะทําจากผ้าที่ทําจากใยคาบอนด์ เพื่อช่วยในการส่งถ่ายประจุไฟฟ้าสถิตย์จากตัวมนุษย์ลงกราวด์ลักษณะการสวมชุด Jump Suit จะมีการสวมตั้งแต่เท้าขึ้นไปถึงศรีษะคล้ายชุดหมี และในการปฏิบัติงานเกี่ยวกับการประกอบไอซีทุกครั้งต้องใส่สายกราวด์ที่ข้อมือ (Wrist Trap) ทุกครั้ง เพื่อป้องกันประจุไฟฟ้าสถิตย์หรือ ESD ที่เกิดจากมนุษย์ไปทําอันตรายต่อโครงสร้างภายในตัวไอซี
จากรูปบล็อคไดอะแกรมที่ 3-2 เป็นบล็อคไดอะแกรมแสดงลําดับขั้นการประกอบไอซีพอสรุปได้ดังนี้
1.
ขั้นการทํา Wafer Mount (W / M)เป็นกระบวนการนําแผ่นเวเฟอร์มาติดแผ่นพลาสติกเหนียว
โดยใช้พลาสติกติดที่ด้านหน้าของแผ่นเวเฟอร์ เพื่อป้องกันเศษของซิลิกอนลงไปอุดร่องของไดบนแผ่นเวเฟอร์ในขณะเจียรไนแผ่นเวเฟอร์
เมื่อติดแผ่นพลาสติกเหนียวเสร็จแล้วจะนําไปผ่านขบวนการเจียรไนต่อไป
2.
ขั้นการเจียรนัยด้านหลังของแผ่นเวเฟอร์ (Backgrinding)ในการผลิตแผ่นเวเฟอร์ที่มีเส้นผ่าศูนย์กลางของแผ่นกว้างขนาด
12" จํ าเป็นอย่างยิ่งที่ทางโรงงานผลิตแผ่นเวเฟอร์ต้องเพิ่มความหนาของแผ่น
เพื่อสะดวกในการขนส่ง เพราะว่าแผ่นเวเฟอร์ที่มีความบางมากประมาณ 10
ไมครอน จะเกิดการแตกหักระหว่างการขนส่งได้ ดังนั้นทางโรงงานผลิดแผ่นเวเฟอร์จึงมีการเพิ่มความหนาของแผ่นเวเฟอร์เป็น
24 ไมครอน เพื่อความสะดวกในการขนส่ง เมื่อขนส่งแผ่นเวเฟอร์มาถึงโรงงานผลิตไอซี
จะมีกระบวนการเจียรไนแผ่นเวเฟอร์ ให้มีขนาดบางลงตามมาตรฐานโรงงาน คือ
มีความหนาประมาณ 10 ไมครอน โดยก่อนจะทําการเจียรไนด้วยหินเจียรไนที่ทําด้วยกากเพชร
ซึ่งกระบวนการเจียรไนแผ่นเวเฟอร์จะมีขั้นตอนการเจียรไนหยาบและเจียรไนละเอียด
โดยในขบวนการเจียรไนจะต้องมีการฉีดนํ้า DI (Deionized) หรือนํ้ าที่ผ่านกระบวนการดึงเอาสารแขวนลอยและสิ่งเจือปนออกจากนํ้าให้นํ้
ามีสภาวะเป็นฉนวนไฟฟ้า เพื่อทําความสะอาดชิ้นงานตลอดเวลา เมื่อทําการเจียรไนแผ่นเวเฟอร์เสร็จแล้วจะนําแผ่นเวเฟอร์มาลอกแผ่นพลาสติกเหนียวออก
โดยใช้เครื่องลอกแผ่นพลาสติกเหนียว โดยใช้สติ๊กเกอร์ที่มีความเหนียวของกาวมากกว่าแผ่นพลาสติกเหนียวที่ติดอยู่บนแผ่นเวเฟอร์
จะทําให้แผ่นพลาสติกเหนียวลอกออกจากแผ่นเวเฟอร์ ลักษณะของเครื่องเจียรไนแผ่นเวเฟอร์ดังแสดงในรูปที่3-3
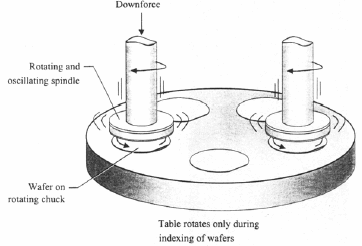
รูปที่ 3-3 แสดงไดอะแกรมมการเจียรไนด้านหลังแผ่นเวเฟอร์
3. กระบวนการ SSOP (Second Sampling Optical Plan)เป็นขั้นตอนการสุ่มตรวจคุณภาพครั้งที่ 2 หลังจากมีการเจียรไนแผ่นเวเฟอร์แล้วว่ามีได(DIE) ตัวใดบ้างที่ชํารุดเนื่องจากการเจียรไนแผ่นเวเฟอร์จะมีการสุ่มตรวจด้วยกล้องขยายที่แผ่นเวเฟอร์และตรวจแผ่นเวเฟอร์ในรูปแบบตัว Z ถ้าไม่พบไดชํารุดถือว่าผ่านการตรวจ แต่ถ้าตรวจพบไดชํารุดเสียหายตั้งแต่ 2 ตัวขึ้นไปจะมีการตรวจไดที่แผ่นเวเฟอร์ 100 % เพื่อวิเคราะห์หาจุดคุ้มทุนของการผลิตดังแสดงในรูปที่ 3-4
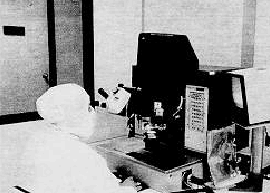
รูปที่ 3-4 แสดงการสุ่มตรวจคุณภาพของได
4. กระบวนการตัดแยกได (Die Saw)การตัดแยกไดทําได้โดยการใช้เครื่องเลื่อยแผ่นเวเฟอร์ (Dimond Bladedicing Saw) ใบเลื่อยที่ใช้ตัดแผ่นเวเฟอร์จะทําจากกากเพชร ในขั้นตอนนี้จะต้องนําแผ่นเวเฟอร์ไปติดกับเฟรมริง(Frame Ring) โดยใช้แผ่นพลาสติกเหนียว เพื่อสะดวกในการจับยึดชิ้นงาน ซึ่งกระบวนการนี้เรียกว่า Wafer Mount (W / M) ดังแสดงในรูปที่ 3-4 (ก) และเมื่อติดแผ่นเวเฟอร์และเฟรมริงเข้าด้วยกันด้วยพลาสติกเหนียวแล้ว ขั้นตอนต่อไปจะนําแผ่นเวเฟอร์ที่จะติดอยู่บนเฟรมริงไปตัดโดยใช้เครื่องตัดแผ่นเวเฟอร์ ซึ่งการตัดแผ่นเวเฟอร์จะตัดทางด้านแกน X และแกน Y ขณะที่ตัดจะมีการฉีดนํ้า DI เพื่อล้างเศษผงซิลิกอนที่ติดอยู่บนชิ้นงานออกให้หมด เพื่อให้ชิ้นงานสะอาด โดยการตัดแผ่นเวเฟอร์ จะตัดเฉพาะแผ่นเวเฟอร์เท่านั้น ไม่ตัดลึกลงถึงแผ่นพลาสติกเหนียวที่ยึดแผ่นเวเฟอร์กับเฟรมริง ในขบวนการต่อไปจะเป็นขบวนการไดแอตแทค (DIE ATTACH) การตัดแผ่นเวเฟอร์ได้ดังแสดงในรูปที่ 3-5 (ก) และ (ข)

(ก) แสดงการยึดแผ่นเวเฟอร์กับเฟรมริง

(ข) แสดงรูปการตัดแผ่นเวเฟอร์ด้วยเครื่องตัด
รูปที่ 3-5
5. กระบวนการไดแอตแทค (DIE ATTACH)เป็นกระบวนการนําแผ่นเวเฟอร์ ที่ผ่านการตัดแล้วมาผ่านกระบวนการแยกไดไปติดบนลีดเฟรม (Lead Frame) ด้วยกาวอีพอกซี่เงิน (Silver Epoxy) จุดที่นําไดไปติดกับลีดเฟรมนี้เรียกว่าเดป (DAP) เมื่อติดไดเสร็จแล้วก็จะนําไปอบด้วยเครื่องอบให้กาวอีพอกซี่แห้ง ดังแสดงในรูปที่ 3-6
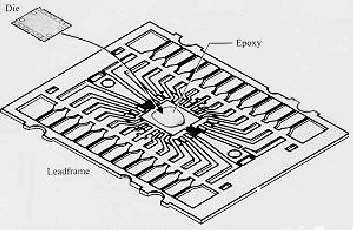
(ก) แสดงตําแหน่งการติดกาวอีพอกซี่
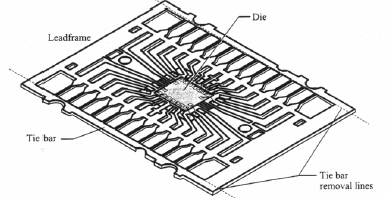
(ข) แสดงการนําไดไปติดบนลีดเฟรมด้วยกาวอีพอกซี่เงิน
รูปที่
3-6
6. กระบวนการ Wire Bond เป็นกระบวนการเชื่อมลวดทองระหว่างไดกับขาลีดเฟรม โดยการเชื่อมต่อลวดทองจะมีการต่อตามไดอะแกรมที่ทางโรงงานกําหนด (Bonding Diagram) วิธีการเชื่อมลวดทอง ที่ใช้ในอุตสาหกรรมการผลิตไอซีมี 3 วิธี ดังต่อไปนี้
• Thermocompression Bonding
• Ultrasonic Bonding
• Thermosonic Ball Bonding
ซึ่งรายละเอียดในการเชื่อมลวดทองลงบนแผ่นไดและลีดเฟรมเราจะได้ศึกษารายละเอียดต่อไปนี้
6.1 การเชื่อมโดยวิธีการ Thermocompression เป็นวิธีการเชื่อมลวดทองระหว่างไดกับขาลีดเฟรมโดยใช้ความร้อนและแรงกดของหัวเชื่อมกดลวดทอง ให้ติดกับแพด (PAD) หรือจุดต่อที่ไดและลีดเฟรม โดยสอดลวดทองผ่านด้านในของหัวเชื่อม ซึ่งมีความร้อนแล้วกดหัวเชื่อมลงไปที่แพดที่อยู่บนไดและโยงลวดทองไปหาขาของลีดเฟรมทําการกดและตัดลวดทอง และทําการเริ่มเชื่อมแพดจุดอื่นต่อไป
6.2 การเชื่อมโดยวิธีการ Ultrasonic Bonding เป็นกระบวนการเชื่อมลวดทองโดยใช้พลังงานคลื่นอัลตร้าโซนิคสั่นและแรงกดของหัวเชื่อมเชื่อมลวดทองให้ติดกับแพดบนไดและลีดเฟรม โดยจะมีการสอดลวดทองผ่านหัวเชื่อมเมื่อกดหัวเชื่อมลงที่ได พลังงานอัลตร้าโซนิคก็จะทําให้เกิดการสั่นที่ปลายหัวเชื่อมด้วยความถี่ 60 KHz จะทําให้ลวดทองติดกับได เลื่อนหัวเชื่อมไปที่ขาของลีดเฟรม แล้วทําการเชื่อมโดยพลังงานอัลตร้าโซนิค เมื่อยกหัวเชื่อมขึ้นเส้นลวดทองจะขาดดังแสดงในรูปที่ 3.7
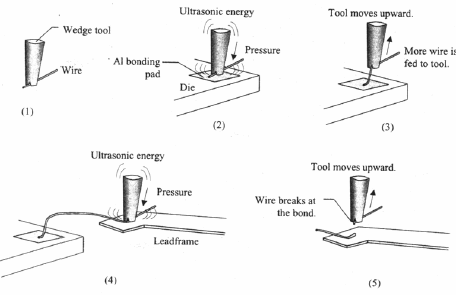
รูปที่ 3-7 แสดงลําดับขั้นการเชื่อมโดยวิธีการ Ultrasonic wire Bonding
6.3 การเชื่อมโดยวิธีการ Theomosonic Ball Bonding เป็นวิธีการเชื่อมลวดทองโดยใช้เทคนิคในการเชื่อมแบบ Ultrasonic Vibration เป็นการเชื่อมลวดทองโดยความร้อนเป่าให้ลวดทองหลอมละลายจนเป็นลูกบอลแล้วใช้แรงกดและการสั่นของคลื่นอัลตร้าโซนิคเพื่อให้ลวดทองติดกับแพดและลีดเฟรม การเชื่อมแบบนี้จะใช้ลวดทองสอดเข้าตรงกลางปลายหัวเชื่อม ในขณะที่ลวดทองเคลื่อนที่ออกมาจะมีความร้อนไปเป่าที่ลวดทอง ให้ลวดทองหลอมละลายเป็นลูกบอลที่มีขนาดเท่ากับ 20 ไมครอน หรือตามขนาดของแพด แล้วกดลงไปยังตําแหน่งจุดต่อสายที่แพด จะทําให้ลวดทองติดที่แพดเป็นแผ่นวงกลมแล้วเคลื่อนหัวเชื่อมไปที่ลีดเฟรม พร้อมกับตัดลวดทอง โดยการยกหัวเชื่อมขึ้นเพื่อที่จะเชื่อมที่แพดถัดไป ดังแสดงในรูปที่ 3-8
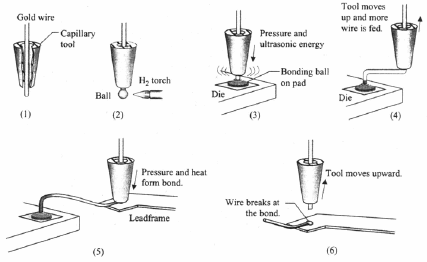
รูปที่ 3-8 แสดงลําดับขั้นการเชื่อมโดยวิธี Thermosonic Ball Bond
เมื่อเราเชื่อมลวดทองที่ขาไดและลีดเฟรม แล้วจะมีการทดสอบแรงดึง (Wire Pull Test)เพื่อทดสอบความแข็งแรงของการเชื่อมการทดสอบแรงดังแสดงในรูปที่ 3-9
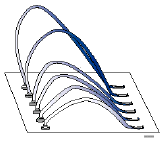
(ก) แสดงลักษณะการเชื่อมต่อของเส้นลวดทองภายในตัวไอซี
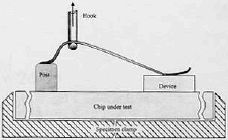
(ข) แสดงวิธีการทดสอบการเชื่อมโดยการดึง
รูปที่
3-9
3.1.2 ส่วนของการผลิต EOL (End of Line)
ในกระบวนการประกอบไอซีในส่วนของกระบวนการผลิตส่วนหน้า (EOL) จะเป็นห้อง CLEAN ROOM ซึ่งห้องดังกล่าวจะต้องมีการควบคุมความสะอาด ฝุ่นละออง ความชื้น และอุณหภูมิภายในห้องประกอบไอซี โดยทางโรงงานมีการกําหนดเขตพื้นที่ CLEAN AREA พนักงานที่จะเข้าไปในเขตดังกล่าวต้องสวมชุดสมอก (SMOCK)ร่วมกับรองเท้า ESD Shoes ซึ่งมีคุณสมบัติเป็นรองเท้าระบายประจุลงพื้นที่ระบายประจุได้อย่างดี ชุดสมอกก็จะเป็นชุดป้องกันประจุไฟฟ้าสถิตย์ (Electro static Discharge) ที่เกิดขึ้นที่ตัวมนุษย์ หรือตัวย่อคือ ESD และใส่สายกราวด์ที่ข้อมือทุกครั้งที่หยิบชิ้นงาน เพื่อป้องกันประจุไฟฟ้าสถิตย์ที่เกิดจากมนุษย์ไปทําอันตรายต่อโครงสร้างภายในตัวไอซีระหว่างการผลิตเมื่อผ่านกระบวนการผลิตในส่วน EOL (End of Line) ที่กระบวนการเชื่อมลวดทอง (Wire Bond) แล้วจะนําผลผลิตที่ได้ไปผ่านกระบวนการ EOL โดยเริ่มตั้งแต่กระบวนการฉีดโมลด์เข้าไปที่แม่พิมพ์ของไอซีแต่ละรูปแบบตาม Package ที่ทางบริษัทกําหนดจนถึงกระบวนการทดสอบไอซี ซึ่งมีกระบวนการตามไดอะแกรมขั้นตอนการผลิตดังต่อไปนี้

รูปที่ 3-10 แสดงไดอะแกรมขั้นตอนการผลิตของกระบวนการ EOL
ในกระบวนการผลิตในส่วนของ EOL เป็นกระบวนการสุดท้ายของของการประกอบไอซีเป็นส่วนสําคัญที่จะต้องควบคุมคุณภาพผลิตที่ส่งลูกค้าของทางบริษัท ซึ่งจะเริ่มมีขั้นตอนการผลิตดังนี้
1. กระบวนการโมลด์ (Mold)
เป็นขั้นตอนการฉีดสารคอมปาวด์ (Compound) หรือวัสดุที่จะฉีดเข้าไปในโมลด์อาทิเช่นพลาสติก เซอรามิค เป็นต้น สารคอมปาวด์จะไปคลุมหน้าไดในลีดเฟรม เพื่อจะได้รูปร่างของไอซีแต่ละรูปแบบตามสเปคที่ทางบริษัทกําหนดดังแสดงในรูปที่ 3-11
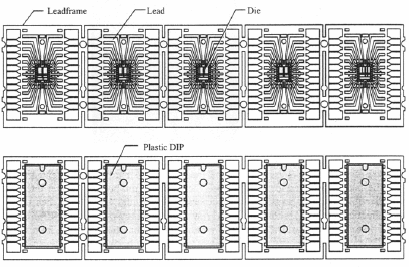
รูปที่ 3-11 แสดงตําแหน่งการฉีดสารคอมปาวด์ลงไปในได
ลักษณะของรูปร่างตัวถังของไอซีมีหลายรูปแบบซึ่งรูปแบบของไอซีจะมีชื่อเรียกต่างกันตามลักษณะการต่อขาดังแสดงในรูปที่ 3-12
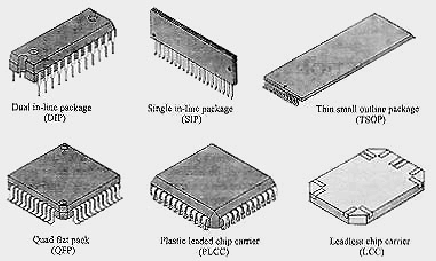
รูปที่ 3-12 แสดงลักษณะรูปร่างของไอซีและการแบ่งประเภทของไอซีตามลักษณ์ของรูปร่าง
2. กระบวนการ Post Mold Cure (P.Cure)
เมื่อผ่านกระบวนการฉีดโมลด์แล้วจะนําไอซีไปอบ (Cure) เพื่อให้สารคอมปาวด์แข็งตัวและขั้นตอนต่อไป จะนําลีดเฟรมที่ผ่านการฉีดโมลด์แล้ว ไปผ่านกระบวนการทดสอบตําแหน่งของลวดทองเมื่อฉีดสารคอมปาวด์เข้าไปยังโมลด์ ว่ามีการเคลื่อนตัวหรือไม่ และทดสอบสารคอมปาวด์ว่ามีการฉีดทั่วถึงโมลด์หรือไม่ มีฟองอากาศในการฉีดโมลด์หรือไม่ ซึ่งกระบวนการทดสอบนี้จะใช้เครื่อง X-ray เป็นเครื่องทดสอบโครงสร้างภายในตัวไอซี
3. กระบวนการ Solder Plate (S/P)
เป็นกระบวนนําสารตะกั่วและดีบุก (ตะกั่ว 63 % + ดีบุก 37 %) มาชุบเคลื่อบผิวทองแดงของขายูนิต โดยใช้หลักการชุบขาทางไฟฟ้าและเคมี เพื่อป้องกันการเกิดออกไซด์บนผิวทองแดงเพราะจะทําให้ขาเฟรมเป็นสนิมนํ ากระแสไฟฟ้าได้ไม่ดี
4. กระบวนการ DTF & S (Deflash Trim Form Singulation) เป็นขั้นตอนการผลิตดังนี้
Deflash (D) ทําหน้าที่ตัดสารคอมปาวด์ส่วนที่เกิดออกจากตัวไอซี
Trim (T) ทํ าหน้าที่ตัดปลายขา Lead / Dam Bar
Forn (F) ทํ าหน้าที่พับขา
Singulation (S) ทําหน้าที่ตัดแยกให้ยูนิตขาดออกเป็นตัว ๆ
5. กระบวนการ FOI (Final Outgoing Inspection)
เป็นกระบวนการตรวจสอบคุณภาพงานตามสเปค ว่ามีตําหนิที่เกิดขึ้นที่ตัวไอซี(BodyPackage) มีตําหนิถือว่าเป็นของเสีย (Reject) และตรวจสอบคุณภาพงานตามสเปค ขั้นตอนต่อไปจะมีการทดสอบคุณสมบัติทางไฟฟ้าต่าง ๆ อาทิเช่น การทดสอบตามฟังก์ชั่นการทํ างาน (Functional Test) การทดสอบพารามิเตอร์ทางด้านไฟตรง (DC Parameter Test) การทดสอบพารามิเตอร์ทางด้านไฟสลับ (AC Parameter Test) ต่อไป
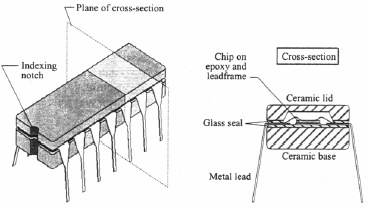
รูปที่ 3-13 แสดผลผลิตที่ผ่านขบวนการ Assembly
3.2 ประเภทของไอซี (IC PACKAGE)
ในโรงงานอุตสาหกรรมการผลิตตัวไอซี สามารถแบ่งประเภทของตัวไอซีตามลักษณะการต่อสัญญาณไปใช้งานได้ดังนี้
• Thru - Hole Technology เป็นเทคโนโลยีที่เกิดขึ้นเมื่อปี ค.ศ. 1960 ซึ่งผลิตไอซีชนิดที่มีขา (Lead) และจะต้องมีการเจาะรูบนแผ่นปริ้นท์ให้ทะลุ เพื่อยึดขาไอซีบนโฮลเพลทโดยการบัดกรี มีข้อเสียคือต้องการพื้นที่บนแผ่นปริ้นท์มาก
• Suface - Mount Technology (SMT) เป็นเทคโนโลยีการผลิตไอซีเกิดขึ้นในปี ค.ศ.1990 ซึ่งเทคโนโลยีแบบนี้ สามารถนําอุปกรณ์ทางด้านอิเล็กทรอนิกส์ไปติดบนแผ่นปริ้นท์ ในเทคโนโลยีการผลิตไอซีจะมีการผลิตไอซีทั้งแบบมีขาและไอซีแบบใช้ลูกบอลต่อแทนขาไอซี (Solder balls) สามารถนําตัวไอซีไปติดบนแผ่นปริ้นท์ได้ เทคโนโลยีการผลิตทั้งสองวิธีเราจะได้ศึกษารายละเอียดต่อไป
3.2.1 ไอซีประเภท Through – Hole
เป็นไอซีชนิดที่มีขา (Lead) และจะต้องมีการเจาะรูบนแผ่นปริ้นท์ให้ทะลุ เพื่อยึดขาไอซีบนโฮลเพลทโดยการบัดกรี ไอซีประเภท Through – Hole ยังสามารถแบ่งย่อย ๆ ได้ตามลักษณะของขาไอซีได้ดังต่อไปนี้
1.
ไอซีประเภท Through – Hole มีขาขางเดียว (Single Side) และไอซีประเภทนี้ยังสามารถแบ่งเป็น
2ประเภท คือ
1.1
ไอซีชนิด SIP (Single Inline Package)
1.2
ไอซีชนิด ZIP (Zig - Zag Inline Package) ลักษณะของไอซีทั้งสองชนิดนี้ดังแสดงในรูป
3-14
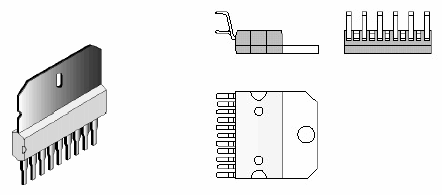
(ก)
ไอซีชนิด SIP (ข)
ไอซีชนิด ZIP
รูปที่
3-14
2. ไอซีประเภท Through – Hole มีขา 2 ด้าน (Dual Side)
ซึ่งบางครั้งถูกเรียกว่าไอซีประเภท DIP (Dual Inline Package) และไอซีประเภทนี้อาจจะแบ่งตามสารคอมปาวด์ ที่ฉีดเข้าไปที่โมลด์ของตัวไอซี อาทิเช่นถ้าฉีดสารพลาสติกเข้าไปจะมีชื่อเรียกว่า P DIP (Plastic Dual Inline Package) ถ้าฉีดสารคอมปาวด์ชนิดเซอรามิกจะถูกเรียกว่า CDIP (Ceramic Dual Inline Package) เป็นต้น ส่วนลักษณะไอซีทั้งสองชนิดนี้ได้แสดงในรูปที่3-15

(ก) รูปไอซี PDIP (ข) รูปไอซี CDIP
รูปที่ 3-15
3. ไอซีประเภท Through – Hole มีขาเต็มพื้นที่ (Full Surface)
เป็นไอซีที่มีขาจํานวนมากตัวอย่างเช่นไอซี CPU ที่ใช้ในคอมพิวเตอร์ หรือบางครั้งจะถูกเรียกว่าไอซีชนิด PPGA (Plastic Pin Grid Array) ลักษณะของรูปร่างไอซีชนิด PPGA ดังแสดงในรูปที่ 3-16
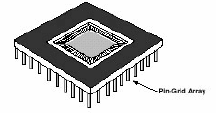
รูปที่ 3-16 แสดงรูปลักษณะของไอซี PPGA
3.2.2 ไอซีประเภท Surface Mount
เป็นเทคโนโลยีการผลิตไอซีที่เกิดขึ้นประมาณปี
ค.ศ. 1990 เทคโนโลยีแบบนี้ สามารถนําอุปกรณ์ทางด้านอิเล็กทรอนิกส์ไปติดบนแผ่นปริ้นท์
ซึ่งเทคโนโลยีการผลิตไอซีจะมีการผลิตทั้งแบบมีขาและการผลิตไอซีแบบใช้ลูกบอลเชื่อมต่อแทนขาไอซี
(Solder balls) สามารถนําตัวไอซีไปติดบนแผ่นปริ้นท์ได้ ลักษณะการผลิตไอซีประเภทนี้มีข้อดี
คือลดกระบวนการชุบขาไอซีด้วยสารตะกั่วเป็นการรักษาสิ่งแวดล้อม ขนาดของตัวไอซีมีขนาดเล็กกระทัดรัด
ไอซีมีขนาดบางมาก ใช้ในโทรศัพท์มือถือที่มีขนาดเล็ก ซึ่งไอซีแต่ละประเภทเราจะได้ศึกษารายละเอียดต่อไป
ชนิดของไอซีประเภทนี้สามารถแบ่งตามการเชื่อมขาไอซีบนแผ่นปริ้นท์ได้ดังนี้
• ไอซี Surface Mount ประเภทมีขา (Surface Mount Lead Package)
• ไอซี Surface Mount ประเภทประเภทใช้ลูกบอลแทนขา (Surface Mount Ball Grid Array Package)
3.2.2.1 ไอซี Surface Mount ประเภทมีขา (Surface Mount Lead Package)เป็นไอซีชนิดที่มีการเชื่อมขาไอซีบนแผ่นปริ้นท์ชนิดใช้ขา (Lead) ยังสามารถแบ่งเป็นประเภทย่อย ๆ ได้ดังต่อไปนี้
1. ไอซีประเภทมีขาแถวเดียว (Single Side) เป็นไอซีที่มีการวางตําแหน่งไอซีเป็นแนวตั้งหรือมีชื่อเรียกว่าไอซีชนิด SVP (Surface Vertical - Mount Package) ซึ่งมีลักษณะดังรูปที่ 3-17

รูปที่ 3-17 แสดงลักษณะการต่อขาแบบ SVP
2.ไอซี Surface Mount ประเภทมีขา 2 แถว (Dual Side) ไอซีประเภทนี้ยังแบ่งย่อยออกเป็น 3 ชนิดดังนี้
2.1 ไอซีชนิด SOP (Small - Out Line Package)ไอซีประเภทนี้เป็นไอซีที่มีลักษณะการออแบบเหมือนไอซีประเภท PDIP แต่มีขนาดเล็กและมีความหนาเท่ากับ 0.25 ม.ม. และมีการพับขาแบบ Gull - wing ดังแสดงในรูปที่ 3-18


รูป(ก) แสดงไอซีประเภท SOP รูป(ข) แสดงไอซีประเภท PDIP
รูปที่ 3-19 แสดงการเปรียบเทียบไอซี SOP กับไอซี PDIP 16 ขา
2.2 ไอซีชนิด SSOP (Shirk Small - Out Line Package)เป็นไอซีชนิดขา 2 แถว มีการพับขาแบบที่มีลักษณะเหมือนกับไอซีชนิด SOP แต่มีขนาดย่อให้เล็กลงอีกดังแสดงในรูป 3-20


รูปที่ 3-20 แสดงการเปรียบเทียบไอซีชนิด SOP (รูปซ้าย)และ ไอซีชนิด SSOP (รูปขวามือ)
2.3 ไอซีชนิด Thin Small Outline Package (TSOP)เป็นไอซีชนิดมีขา 2 แถวที่มีขนาดเล็กและบางคือมีความหนาประมาณ 1 ม.ม. ซึ่งมีความหนาน้อยมากเมื่อเทียบกับไอซีประเภท SOP และ SSOP มีการพับขาไอซีแบบ Gull - wingดังแสดงในรูปที่ 3-21 ซึ่งไอซีชนิดนี้มีขนาดบางมากเหมาะสําหรับใช้ในชิ้นส่วนอิเล็กทรอนิกส์ที่มีขนาดเล็ก อาทิเช่น โทรศัพท์มือถือ เป็นต้น

รูปที่ 3-21 แสดงรูปไอซีชนิด TSOP
3.ไอซี Small-outline -Lead Package ( SOJ )เป็นไอซีประเภทขา 2 แถว ที่มีการพับขาแบบ J-Bend รูปร่าง และมีลักษณะดังแสดงดังในรูปที่ 3-22

รูปที่ 3-22 แสดงรูปไอซีชนิด SOJ
4.ไอซี Surface Mount ประเภทมีขา 4 แถว (Quadruple Side)เป็นไอซีที่ต่อขา 4 แถว ที่ถูกพัฒนาขึ้นภายใต้หลักการพื้นฐานคือ ให้มีจํ านวนขาไอซีมากกว่าไอซี DIP และ SOP ซึ่งไอซี Surface Mount ประเภทมีขา 4 แถว ยังสามารถแบ่งออกได้เป็น 3ชนิดดังนี้
• ไอซีชนิด QFP ( Quad Flat Package )
• ไอซีชนิด TQFP ( Thin Quad Flat Package )
• ไอซีชนิด QFJ (Quad Flat J-Lead Package )
ซึ่งรายละเอียดของไอซีแต่ละชนิดเราจะได้ศึกษาต่อไป
4.1 ไอซีชนิด QFP (Quad Flat Package)เป็นไอซีที่ถูกพัฒนาขึ้นมาภายใต้พื้นฐานคือ มีจํานวนขามาก มีขนาดของไดขนาดใหญ่และมีการพัฒนาไอซีแบบ Gull-Wing เพื่อให้ระบายความร้อนได้ดี ลักษณะของรูปร่างของไอซี ดังแสดงในรูปที่ 3-23


รูป3-24 แสดงไอซีประเภท QFP
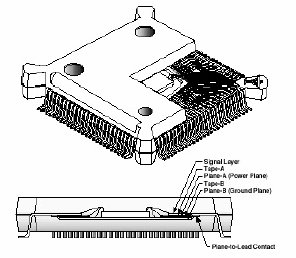
รูปที่ 3-25 แสดงรูปการเชื่อมลวดทองแดงเข้าไปในไดและ Lead Frameของไอซีประเภท QFP
4.2 ไอซีชนิด ชนิด TQFP (Thin Quad Flat Package)


รูปที่ (ก) ไอซีประเภท QFP รูปที่ (ข) ไอซีประเภท TQFP
รูปที่ 3-26 แสดงการเปรียบเทียบไอซีประเภท QFP และ TQFP
จากรูปที่ 3-26 แสดงการเปรียบเทียบไอซีประเภท QFP และ TQFP ซึ่งจะมีกระบวนการผลิตเหมือนกันแตjมีขนาดและความหนาต่างกัน มีการพับขาแบบ Gull-Wing
4.3 ไอซีชนิด QFJ (Quad Flat J-Lead Package)เป็นไอซีที่มีขา 4 แถวและมีการพับขาไอซีแบบ J-BEND ดังแสดงในรูปที่ 3-27

รูปที่ 3-27 แสดงไอซีชนิด QFJ
5. Ball Grid Array Package (BGA)
เทคโนโลยีการผลิตไอซีแบบ BGA เป็นเทคโนโลยี่ใหม่ล่าสุดในกระบวนการผลิตไอซีที่มีการคิดค้นขึ้นเมื่อปี ค.ศ. 1990 อันเนื่องจากการประกอบไอซีแบบมีขา (Lead) ขั้นตอนการผลิตที่ยุ่งยากมีขั้นการผลิตมาก จะต้องมีกระบวนการชุบขาไอซี (Solder Plate) กระบวนการดังกล่าวจะมีสารเคมีและสารตะกั่วเกิดขึ้นในการชุบขาไอซีเพื่อเป็นการรักษาสิ่งแวดล้อมที่เกิดขึ้น วิศวกรในการออกแบบไอซีจึงคิดค้นวิธีการผลิตไอซีแบบ Ball Grid Array (BGA) ขึ้นซึ่งวิธีการดังกล่าวจะใช้ลูกบอลขนาดเล็ก 20 มิล(Mil)หรือ 20/1000 นิ้วแทนขาไอซี ลักษณะการออกแบบ BGA มีข้อดีคือสามารถผลิตไอซีที่มีขนาดเล็กและบาง มีจํานวนขามากถึง 2400 ขา ตามลักษณะการออกแบบและมีนํ้าหนักเบาสามารถออกแบบผลิตภัณฑ์ทางด้านอิเล็ กทรอนิกส์ให้ มีขนาดเล็กได้อาทิเช่นโทรศัพท์มือถือขนาดเล็ก เป็นต้น ลักษณะการต่อขาของไอซีดังแสดงในรูปที่ 3-28

รูปที่ 3-28 ลักษณะการตjอขาไอซีประเภท BGA
ชนิดของไอซีประเภท Ball Grid Array Packages (BGA)สามารถแบ่งเป็นไอซีตระกูลต่างๆได้ดังนี้
• เซอรามิกบอลกริดอาเรย์ (Ceramic Ball Grid Array)
• พลาสติบอลกริดอาเรย์ (PlasticBall Grid Array)
ซึ่งลักษณะโครงสร้างของไอซีประเภท BGA จะมีโครงสร้างดังแสดงในรูปที่ 3-29
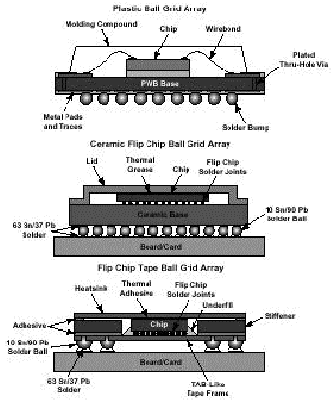
รูปที่ 3-29 แสดงรูปโครงสร้างไอซีในกลุ่ม BGA
จากรูปที่
3-29 เป็นโครงสร้างของไอซีทั้ง 3 ตระกูลซึ่งจะมีพลาสติก PWB หรือทําจากพลาสติกลามิเนทเป็นฐาน
(Base) สําหรับติดตั้งชิปหรือได ในไอซีชนิดพลาสติบอลกริดอาเรย์(Plastic
Ball Grid Array) ส่วนในไอซีชนิดเซอรามิคบอลกริดอาเรย์จะใช้เซอรามิคติดตั้งเป็นฐานสําหรับติดตั้งชิป
และในไอซีชนิดฟลิปชิปเทปบอลกริดอาเรย์ (Flip Tape Ball Grid Array)
จะใช้เทปแฟรม (Tape Frame) เป็นฐานสํ าหรับติดตั้งชิป เป็นต้น
ลักษณะของไอซีชนิดพลาสติกบอลกริดอาเรย์และเซอรามิคบอลกริดอาเรย์จะเป็นไอซีที่มีจุดต่ออุปกรณ์เข้าและออกจํานวนมาก
ซึ่งจุดต่อดังกล่าวจะใช้ลูกบอลเชื่อม (Solder ball) เหมือนกัน แต่ไอซีชนิดเซรามิคบอลกริดอาเรย์
จะมีคุณสมบัติดีกว่าไอซีชนิดพลาสติกบอลกริดอาเรย์ คือสามารถระบายความร้อนได้ดีกว่าไอซีชนิดพลาสติกบอลกริดอาเรย์
ลักษณะรูปร่างของไอซีทั้งสองชนิดมีลักษณะดังรูปที่ 3-30

รูปที่ 3-30 แสดงรูปไอซีชนิด PBGA
ซึ่งลักษณะโครงสร้างภายในของไอซีชนิด PBGA จะมีลักษณะรูปที่ 3-31
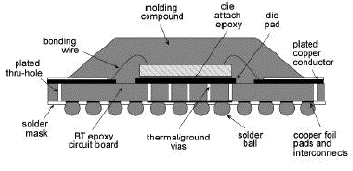
รูปที่ 3-31 แสดงโครงสร้างภายในของไอซี PBGA
จากรูปที่ 3-31 แสดงโครงสร้างภายในของไอซีชนิด PBGA ซึ่งประกอบไปด้วยฐานรองรับไดหรือชิป (Substrate) จะทําจาก High – temperature Epoxy Laminate ด้านบนพลาสติกลามิเนทจะเป็นเพลททองแดงเป็นจุดเชื่อมต่อลวดทอง (Bond Pads) เข้ากับไดที่ติดอยู่กับไดเพลด(Die Pad) ที่จุดเชื่อมลวดทองจะต่อไปที่ Copper Traces ซึ่งจะไปเชื่อมต่อกับลูกบอลที่ทําด้วยตะกั่ว (Solder Ball) การบัดกรีตัวไอซีชนิด PBGA ลงไปที่แผ่นปริ้นท์จะมีการตรวจสอบตําแหน่งของไอซีและอุปกรณ์ โดยใช้แสงกําหนดตําแหน่งการวางตัวไอซีและผ่านกระบวนการอบด้วยอุณหภูมิสูงเพื่อให้ไอซีติดกับแผ่นปริ้นท์ดังแสดงในรูปที่ 3-32

รูปที่ 3-32 แสดงการเชื่อมต่อขาไอซีแบบ PBGA
5.1 ชนิดของไอซีประเภท Chip Size และ Chip Scale Pack (CSP)ลักษณะของไอซีประเภทนี้ จะมีขนาดใกล้เคียงกับขนาดของได เป็นไอซีที่มีลักษณะการต่อขาด้วยลูกบอลขนาดเล็กและบางมาก ใช้เป็นไอซีหน่วยความจําต้องการให้ประหยัดพื้นที่การวางตัวไอซีชนิด TSOP (Thin Small Outline Package) ไอซีชนิด SOIC (Small Outline Package) ไอซีชนิด SSOP (Shirk Small Outline Package) ดังแสดงในรูปที่ 3-33

รูปที่
3-33 แสดงการเปรียบเทียบไอซีชนิด Fine Ball Grid Array (FBGA)
และไอซีชนิด
Micro Ball Grid Array (µBGA)
ชนิดของไอซีประเภท Chip Size Scale สามารถแบ่งออกได้เป็น 2 ชนิดคือ
• Fine Pitch Ball Grid Array Packages
• Micro Ball Grid Array Packages
5.1.1 Fine Pitch Ball Grid Array (FPBGA) ไอซีตระกูล FBGA Packages จะใช้วิธีการเชื่อมลวดทองจากไดไปยังจุดเชื่อมต่อลวดทอง(Ball Pad) ซึ่งโครงสร้างการเชื่อมต่อลูกบอลเหมือนกระบวนการผลิตแบบ BGA แต่ขนาดของลูกบอลที่มีขนาดเล็กมากคือขนาดเล็กเท่ากับ 0.8 มิลิเมตร ซึ่งขนาดของไอซีชนิดนี้มีตัวเล็กมากแต่มีขนาดโตกว่าไอซีชนิด MPBGA ลักษณะของไอซีชนิด FPBGA ดังแสดงในรูปที่ 3-34

รูปที่ 3-34 แสดงรูปร่างของไอซีชนิด FPBGA
โครงสร้างภายในไอซีชนิด FPBGA จะมีโครงสร้างของไอซีประเภท BGA โดยทั่วไปขนาดของตัวไอซีจะมีขนาดเล็กใกล้เคียงกับขนาดของไดดังแสดงในรูปที่ 3-35

รูปที่ 3-35 แสดงโครงสร้างภายในตัวไอซี FBGA
5.1.2 Micro Ball Grid Array (µBGA)ขนาดของไอซีชนิดนี้มีขนาดใกล้เคียงกับขนาดของไดหรือชิปไอซีชนิดนี้มีขนาดเล็กกว่าไอซีชนิด FBGA ไอซีชนิด µBGA และ FBGA ถูกสร้างขึ้นเป็นไอซีหน่วยความจํ าชนิด FlashMemory ดังแสดงในรูปที่ 3-36

รูปที่ 3-36 แสดงลักษณะของไอซี µBGA

รูปที่ 3-37 แสดงลักษณ์โครงสรhางของไอซีประเภท µBGA
จากโครงสร้างภายในของไอซี µBGA ในรูปที่ 3-37 จะเห็นว่าขนาดของไดจะเป็นตัวกําหนดขนาดไอซีและไดจะวางอยู่บนพลาสติกฟีล์มซึ่งมีแผ่นเพลทของ (Gold Plated Copper) ติดอยู่บนแผ่นพลาสติกพิมพ์ แผ่นเพลททองจะต่อไปยังจุดเชื่อมบนไดโดยตรง โดยจะใช้ Elastomer เป็นตัวกั้นระหว่างไดกับแผ่นเพลททองส่วนด้านล่างของโครงสร้างไอซีจะติดลูกบอลตะกั่ว(Solder Ball) ในตําแหน่งที่ต้องการต่อขาสัญญาณ I/O บนแผ่นปริ้นท์
สรุป
การประกอบไอซีมีขั้นตอนการประกอบไอซีดังนี้
• FOL (Front of Line)
- การเจียรหลัง (Back Grinding)
- การแยกได (Die Saw)
- การติดได (Die Attach)
- การเชื่อมต่อสายโดยใช้ลวดทอง
• EOL (End of Line)
- การฉีดโมลด์ (Mold)
- การตรวจสอบความสมบูรณ์ของไอซี (Post Mold Cure)
- การชุบขาไอซี (Solder Plate)
- การตัด พับขาและแยกขาไอซี (DTFS)
- การทดสอบ (Test)
• ประเภทของไอซีแบ่งออกได้เป็น 2 ประเภทใหญ่ๆ คือ
- Throgh – Hole Technology
- Surface – Mount Technology